Kāpēc mūsdienu mikroshēmas kļūst karstas
Nanoskalas tranzistoriem pārslēdzoties ar gigahercu frekvenci, elektroni plūst cauri ķēdēm un zaudē enerģiju siltuma veidā — tādu pašu siltumu, kādu jūtat, kad klēpjdators vai tālrunis kļūst nepatīkami silts. Lielāka tranzistoru skaita izvietošana mikroshēmā atstāj mazāk vietas, kur šo siltumu noņemt. Siltums nevis vienmērīgi izplatās pa silīciju, bet uzkrājas karstajos punktos, kas var būt par desmitiem grādu karstāki nekā apkārtējie apgabali. Lai izvairītos no bojājumiem un veiktspējas zuduma, sistēmas ierobežo centrālo procesoru un grafisko procesoru jaudu, kad temperatūra paaugstinās.
Termiskā izaicinājuma apjoms
Tas, kas sākās kā miniaturizēšanas sacensība, ir pārvērties par cīņu ar karstumu visā elektronikā. Datortehnoloģijās veiktspēja turpina palielināt jaudas blīvumu (atsevišķi serveri var patērēt desmitiem kilovatu). Komunikācijā gan digitālajām, gan analogajām shēmām ir nepieciešama lielāka tranzistora jauda, lai nodrošinātu spēcīgākus signālus un ātrāku datu pārraidi. Jaudas elektronikā labāku efektivitāti arvien vairāk ierobežo termiskie ierobežojumi.
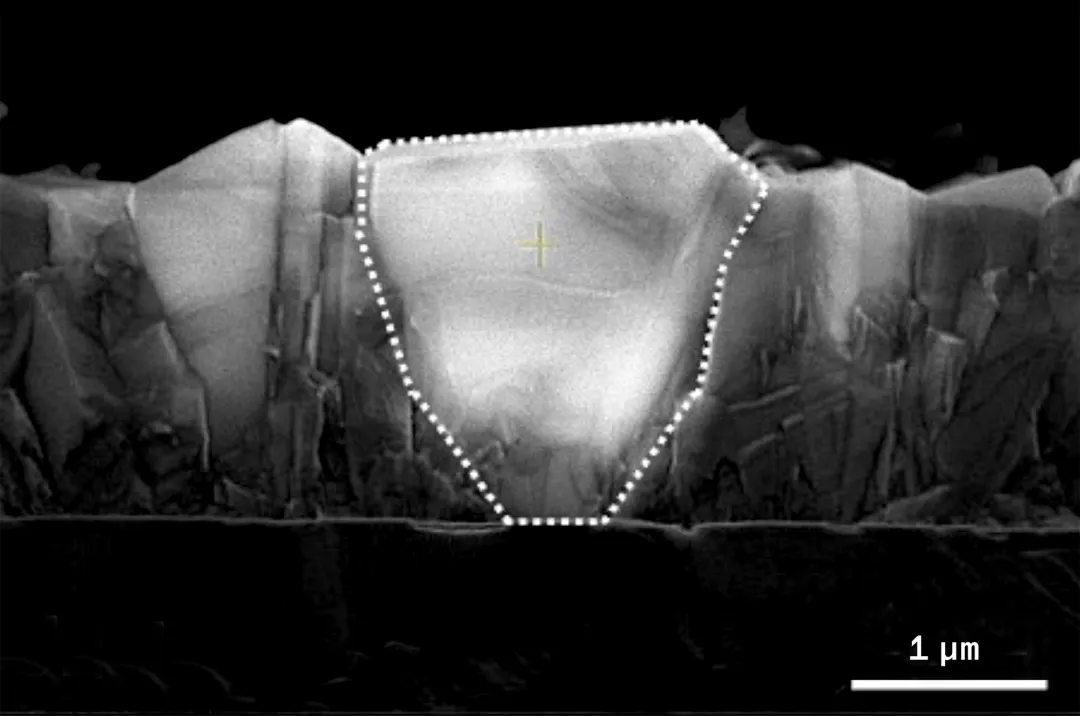
Cita stratēģija: izplatīt siltumu mikroshēmas iekšpusē
Tā vietā, lai ļautu siltumam koncentrēties, daudzsološa ideja iratšķaidītto pašā mikroshēmā — līdzīgi kā ielejot tasi verdoša ūdens peldbaseinā. Ja siltums izplatās tieši tur, kur tas rodas, karstākās ierīces paliek vēsākas un parastie dzesētāji (dzesēšanas izlietnes, ventilatori, šķidruma cilpas) darbojas efektīvāk. Tam ir nepieciešamsaugstas siltumvadītspējas, elektriski izolējošs materiālsintegrēti tikai nanometri no aktīvajiem tranzistoriem, neietekmējot to jutīgās īpašības. Negaidīts kandidāts atbilst šim aprakstam:dimants.
Kāpēc dimants?
Dimants ir viens no labākajiem zināmajiem siltumvadītājiem — vairākas reizes labāks nekā varš —, vienlaikus būdams arī elektriskais izolators. Āķis ir integrācija: tradicionālajām audzēšanas metodēm ir nepieciešama temperatūra aptuveni 900–1000 °C vai augstāka, kas sabojātu modernas shēmas. Jaunākie sasniegumi liecina, ka plānaspolikristālisks dimantsplēves (tikai dažus mikrometrus biezas) var audzēt piedaudz zemākas temperatūraspiemērots gatavām ierīcēm.

Mūsdienu dzesētāji un to ierobežojumi
Dzesēšanas pamatstraume koncentrējas uz labākiem siltuma izlietnēm, ventilatoriem un saskarnes materiāliem. Pētnieki pēta arī mikrofluidisko šķidruma dzesēšanu, fāzes maiņas materiālus un pat serveru iegremdēšanu termiski vadošos, elektriski izolējošos šķidrumos. Šie ir svarīgi soļi, taču tie var būt apjomīgi, dārgi vai slikti piemēroti jaunajiem apstākļiem.3D sakrautsmikroshēmu arhitektūras, kur vairāki silīcija slāņi uzvedas kā “debesskrāpis”. Šādos slāņos katram slānim ir jāizvada siltums; pretējā gadījumā karstie punkti paliek iesprostoti iekšpusē.
Kā izaudzēt ierīcei draudzīgu dimantu
Monokristāla dimantam ir ārkārtēja siltumvadītspēja (≈2200–2400 W m⁻¹ K⁻¹, aptuveni sešas reizes vairāk nekā varam). Vieglāk izgatavojamas polikristāliskas plēves var sasniegt šīs vērtības, ja tās ir pietiekami biezas, un tās joprojām ir pārākas par varu pat tad, ja ir plānākas. Tradicionālā ķīmiskā tvaiku uzklāšana reaģē ar metānu un ūdeņradi augstā temperatūrā, veidojot vertikālas dimanta nanokolonnas, kas vēlāk saplūst plēvē; līdz tam laikam slānis ir biezs, sasprindzināts un pakļauts plaisāšanai.
Zemākas temperatūras augšanai nepieciešama cita recepte. Vienkārši samazinot siltumu, iegūst vadošus kvēpus, nevis izolējošu dimantu.skābeklisnepārtraukti kodina oglekli, kas nav dimanta materiāls, tādējādi nodrošinotlielgraudains polikristālisks dimants ~400 °C temperatūrā, temperatūra, kas ir saderīga ar progresīvām integrētajām shēmām. Tikpat svarīgi ir tas, ka process var pārklāt ne tikai horizontālas virsmas, bet arīsānu sienas, kas ir svarīgi ierīcēm, kurām piemīt 3D funkcija.
Termiskā robežpretestība (TBR): fononu sašaurinājums
Siltumu cietās vielās pārnes arfononi(kvantētas režģa vibrācijas). Materiālu saskarnēs fononi var atstaroties un sakrāties, radottermiskā robežpretestība (TBR)kas kavē siltuma plūsmu. Saskarņu inženierija cenšas samazināt TBR, taču izvēles iespējas ierobežo pusvadītāju saderība. Noteiktās saskarnēs sajaukšanās var veidot plānusilīcija karbīds (SiC)slānis, kas labāk atbilst fononu spektriem abās pusēs, darbojoties kā "tilts" un samazinot TBR, tādējādi uzlabojot siltuma pārnesi no ierīcēm uz dimantu.
Testa platforma: GaN HEMT (radiofrekvences tranzistori)
Augstas elektronu mobilitātes tranzistori (HEMT), kuru pamatā ir gallija nitrīda vadības strāva 2D elektronu gāzē, ir iecienīti augstas frekvences un lielas jaudas darbības dēļ (ieskaitot X joslu ≈8–12 GHz un W joslu ≈75–110 GHz). Tā kā siltums tiek ģenerēts ļoti tuvu virsmai, tie ir lielisks jebkura in situ siltuma izkliedes slāņa zondes elements. Kad ierīci, ieskaitot sānu sienas, iekapsulē plāns dimants, ir novērots, ka kanālu temperatūra pazeminās par~70 °C, ar ievērojamiem termiskās rezerves uzlabojumiem pie lielas jaudas.
Dimants CMOS un 3D steks
Progresīvajā skaitļošanā3D sakraušanapalielina integrācijas blīvumu un veiktspēju, bet rada iekšējus termiskus sašaurinājumus vietās, kur tradicionālie, ārējie dzesētāji ir vismazāk efektīvi. Dimanta integrēšana ar silīciju atkal var radīt labvēlīgu rezultātu.SiC starpslānis, iegūstot augstas kvalitātes termisko saskarni.
Viena no piedāvātajām arhitektūrām irtermiskās sastatnes: nanometru plānas dimanta loksnes, kas iestrādātas virs tranzistoriem dielektriķa iekšpusē un savienotas arvertikālās termiskās atveres (“siltuma stabi”)izgatavoti no vara vai papildu dimanta. Šie balsti nodod siltumu no slāņa uz slāni, līdz tas sasniedz ārēju dzesētāju. Simulācijas ar reālistiskām darba slodzēm liecina, ka šādas struktūras var samazināt maksimālās temperatūras,līdz lieluma kārtaikoncepcijas pierādījumu komplektos.
Kas joprojām ir grūti
Galvenās problēmas ietver dimanta augšējās virsmas izgatavošanu.atomiski plakanslai nodrošinātu nemanāmu integrāciju ar pārklājošajiem savienojumiem un dielektriķiem, kā arī pilnveidotu procesus, lai plānās plēves saglabātu lielisku siltumvadītspēju, neradot slodzi pamatā esošajām shēmām.
Perspektīva
Ja šīs pieejas turpinās attīstīties,dimanta siltuma izplatīšanās mikroshēmāvarētu ievērojami atvieglot CMOS, RF un jaudas elektronikas termiskos ierobežojumus, nodrošinot augstāku veiktspēju, lielāku uzticamību un blīvāku 3D integrāciju bez parastajām termiskajām sekām.
Publicēšanas laiks: 2025. gada 23. oktobris
