Ievads silīcija karbīdā
Silīcija karbīds (SiC) ir salikts pusvadītāju materiāls, kas sastāv no oglekļa un silīcija, un tas ir viens no ideāliem materiāliem augstas temperatūras, augstas frekvences, lielas jaudas un augstsprieguma ierīču ražošanai. Salīdzinot ar tradicionālo silīcija materiālu (Si), silīcija karbīda joslas atstarpe ir 3 reizes lielāka nekā silīcijam. Silīcija vadītspēja ir 4–5 reizes lielāka nekā silīcijam; sabrukšanas spriegums ir 8–10 reizes lielāks nekā silīcijam; elektroniskās piesātinājuma nobīdes ātrums ir 2–3 reizes lielāks nekā silīcijam, kas atbilst mūsdienu rūpniecības vajadzībām pēc lielas jaudas, augsta sprieguma un augstas frekvences. To galvenokārt izmanto ātrdarbīgu, augstas frekvences, lielas jaudas un gaismu emitējošu elektronisko komponentu ražošanā. Pakārtotās pielietojuma jomas ir viedie tīkli, jaunas enerģijas transportlīdzekļi, fotoelektriskā vēja enerģija, 5G komunikācija utt. Silīcija karbīda diodes un MOSFET ir komerciāli pielietoti.

Augsta temperatūras izturība. Silīcija karbīda joslas platums ir 2–3 reizes lielāks nekā silīcijam, elektroni augstā temperatūrā nepārvietojas viegli un var izturēt augstāku darba temperatūru, un silīcija karbīda siltumvadītspēja ir 4–5 reizes lielāka nekā silīcijam, padarot ierīces siltuma izkliedi vieglāku un sasniedzot augstāku darba temperatūru. Augstas temperatūras izturība var ievērojami palielināt jaudas blīvumu, vienlaikus samazinot dzesēšanas sistēmas prasības, padarot termināli vieglāku un mazāku.
Izturēt augstu spiedienu. Silīcija karbīda elektriskā lauka stiprums ir 10 reizes lielāks nekā silīcijam, kas var izturēt augstāku spriegumu un ir piemērotāks augstsprieguma ierīcēm.
Augstas frekvences pretestība. Silīcija karbīda piesātinātā elektronu dreifa ātrums ir divreiz lielāks nekā silīcijam, kā rezultātā izslēgšanas procesā nav strāvas atdalīšanās, kas var efektīvi uzlabot ierīces pārslēgšanās frekvenci un realizēt ierīces miniaturizāciju.
Zemi enerģijas zudumi. Salīdzinot ar silīcija materiālu, silīcija karbīdam ir ļoti zema ieslēgšanās pretestība un zemi ieslēgšanās zudumi. Vienlaikus silīcija karbīda lielā joslas platums ievērojami samazina noplūdes strāvu un jaudas zudumus. Turklāt silīcija karbīda ierīcei izslēgšanas procesā nav strāvas vilkšanas fenomena, un pārslēgšanās zudumi ir zemi.
Silīcija karbīda rūpniecības ķēde
Tas galvenokārt ietver substrātu, epitaksiju, ierīču projektēšanu, ražošanu, blīvēšanu un tā tālāk. Silīcija karbīds no materiāla līdz pusvadītāju barošanas ierīcei piedzīvos monokristāla audzēšanu, lietņu griešanu, epitaksiālu augšanu, plātņu projektēšanu, ražošanu, iepakošanu un citus procesus. Pēc silīcija karbīda pulvera sintēzes vispirms tiek izgatavots silīcija karbīda lietnis, un pēc tam, griežot, slīpējot un pulējot, iegūst silīcija karbīda substrātu, un epitaksiālo audzēšanu iegūst epitaksiālā loksne. Epitaksiālā plāksne tiek izgatavota no silīcija karbīda, izmantojot litogrāfiju, kodināšanu, jonu implantāciju, metāla pasivāciju un citus procesus, plāksne tiek sagriezta matricā, ierīce tiek iepakota, un ierīce tiek apvienota speciālā apvalkā un salikta modulī.
Augšup no rūpniecības ķēdes 1: substrāts — kristālu augšana ir galvenā procesa saikne
Silīcija karbīda substrāts veido aptuveni 47% no silīcija karbīda ierīču izmaksām, un visaugstākie ražošanas tehniskie šķēršļi, vislielākā vērtība, ir SiC turpmākās liela mēroga industrializācijas pamatā.
No elektroķīmisko īpašību atšķirību viedokļa silīcija karbīda substrātu materiālus var iedalīt vadošos substrātos (pretestības apgabals 15–30 mΩ·cm) un daļēji izolētos substrātos (pretestība augstāka par 105 Ω·cm). Šie divi substrātu veidi tiek izmantoti atsevišķu ierīču, piemēram, barošanas ierīču un radiofrekvenču ierīču, ražošanai pēc epitaksiālās audzēšanas. Starp tiem daļēji izolēts silīcija karbīda substrāts galvenokārt tiek izmantots gallija nitrīda RF ierīču, fotoelektrisko ierīču u. c. ražošanā. Audzējot gan epitaksiālo slāni uz daļēji izolēta SIC substrāta, tiek sagatavota SIC epitaksiālā plāksne, ko var tālāk sagatavot HEMT gan izonitrīda RF ierīcēs. Vadītspējīgs silīcija karbīda substrāts galvenokārt tiek izmantots barošanas ierīču ražošanā. Atšķirībā no tradicionālā silīcija jaudas ierīču ražošanas procesa, silīcija karbīda jaudas ierīci nevar tieši izgatavot uz silīcija karbīda substrāta, silīcija karbīda epitaksiālais slānis ir jāaudzē uz vadoša substrāta, lai iegūtu silīcija karbīda epitaksiālo loksni, un epitaksiālais slānis tiek ražots uz Šotki diodes, MOSFET, IGBT un citām jaudas ierīcēm.
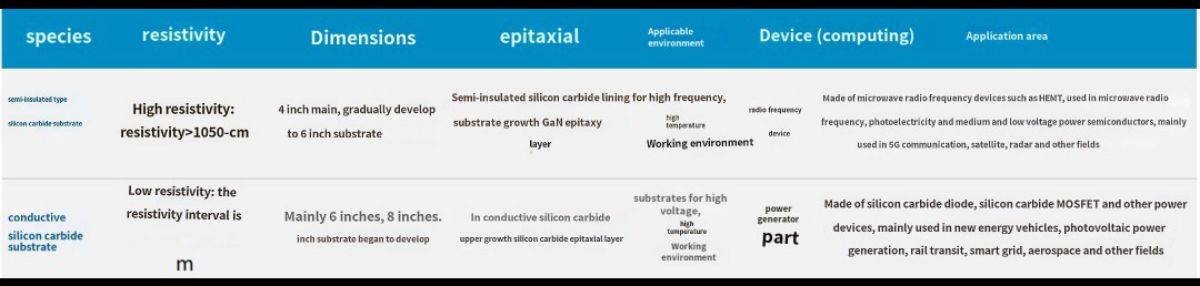
Silīcija karbīda pulveris tika sintezēts no augstas tīrības pakāpes oglekļa pulvera un augstas tīrības pakāpes silīcija pulvera, un dažāda izmēra silīcija karbīda stieņi tika audzēti īpašā temperatūras laukā, un pēc tam, izmantojot vairākus apstrādes procesus, tika iegūts silīcija karbīda substrāts. Galvenais process ietver:
Izejvielu sintēze: Augstas tīrības pakāpes silīcija pulveris + toneris tiek sajaukts saskaņā ar formulu, un reakcija tiek veikta reakcijas kamerā augstā temperatūrā virs 2000 °C, lai sintezētu silīcija karbīda daļiņas ar noteiktu kristāla tipu un daļiņu izmēru. Pēc tam, izmantojot saspiešanas, sijāšanas, tīrīšanas un citus procesus, lai izpildītu augstas tīrības pakāpes silīcija karbīda pulvera izejvielu prasības.
Kristālu audzēšana ir silīcija karbīda substrāta ražošanas pamatprocess, kas nosaka silīcija karbīda substrāta elektriskās īpašības. Pašlaik galvenās kristālu audzēšanas metodes ir fizikālā tvaiku pārnese (PVT), augstas temperatūras ķīmiskā tvaiku pārnese (HT-CVD) un šķidrfāzes epitaksija (LPE). Starp tām PVT metode pašlaik ir galvenā SiC substrāta komerciālās audzēšanas metode, tai ir visaugstākā tehniskā brieduma pakāpe un tā tiek visplašāk izmantota inženierzinātnēs.

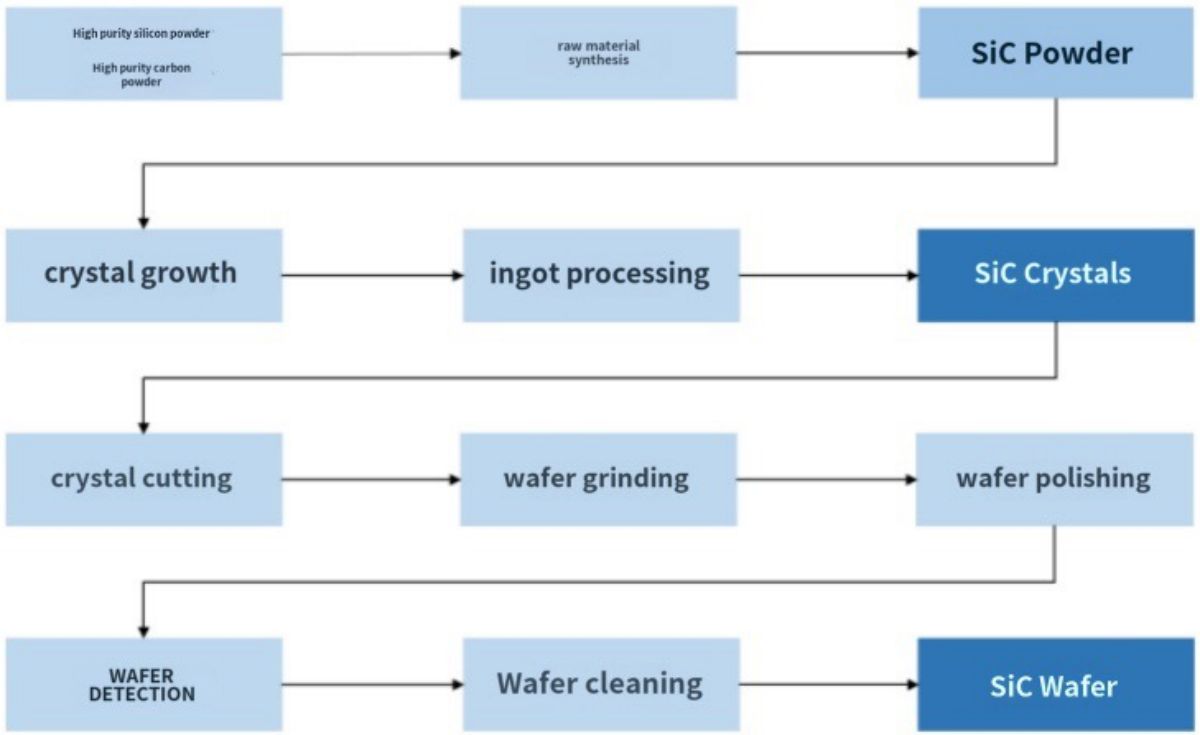
SiC substrāta sagatavošana ir sarežģīta, kas noved pie tā augstās cenas.
Temperatūras lauka kontrole ir sarežģīta: Si kristāla stieņa audzēšanai nepieciešama tikai 1500 ℃ temperatūra, savukārt SiC kristāla stieņa audzēšanai nepieciešama augsta temperatūra virs 2000 ℃, un ir vairāk nekā 250 SiC izomēru, taču galvenā 4H-SiC monokristāla struktūra jaudas ierīču ražošanai, ja tā netiek precīzi kontrolēta, iegūs citas kristāla struktūras. Turklāt temperatūras gradients tīģelī nosaka SiC sublimācijas pārneses ātrumu un gāzveida atomu izvietojumu un augšanas režīmu uz kristāla saskarnes, kas ietekmē kristāla augšanas ātrumu un kristāla kvalitāti, tāpēc ir jāizveido sistemātiska temperatūras lauka kontroles tehnoloģija. Salīdzinot ar Si materiāliem, SiC ražošanas atšķirība ir arī augstas temperatūras procesos, piemēram, augstas temperatūras jonu implantācijā, augstas temperatūras oksidācijā, augstas temperatūras aktivācijā un cietās maskas procesā, kas nepieciešams šiem augstas temperatūras procesiem.
Lēna kristāla augšana: Si kristāla stieņa augšanas ātrums var sasniegt 30–150 mm/h, un 1–3 m silīcija kristāla stieņa ražošana aizņem tikai aptuveni 1 dienu; piemēram, SiC kristāla stienim ar PVT metodi augšanas ātrums ir aptuveni 0,2–0,4 mm/h, 7 dienu laikā tas izaug mazāks par 3–6 cm, augšanas ātrums ir mazāks par 1% no silīcija materiāla, un ražošanas jauda ir ārkārtīgi ierobežota.
Augsti produkta parametri un zema raža: SiC substrāta galvenie parametri ietver mikrotubulu blīvumu, dislokācijas blīvumu, pretestību, deformāciju, virsmas raupjumu utt. Atomu izvietošana slēgtā augstas temperatūras kamerā un kristālu augšanas pabeigšana, vienlaikus kontrolējot parametru indeksus, ir sarežģīta sistēmu inženierija.
Materiālam ir augsta cietība, augsta trauslums, ilgs griešanas laiks un augsts nodiluma līmenis: SiC Mosa cietība 9,25 ir otrajā vietā aiz dimanta, kas ievērojami palielina griešanas, slīpēšanas un pulēšanas grūtības, un 3 cm bieza lietņa 35–40 gabalu sagriešana aizņem aptuveni 120 stundas. Turklāt, pateicoties SiC augstajam trauslumam, plākšņu apstrādes nodilums būs lielāks, un izlaides attiecība ir tikai aptuveni 60%.
Attīstības tendence: Izmēra pieaugums + cenas samazinājums
Globālā SiC tirgus 6 collu apjoma ražošanas līnija tuvojas briedumam, un vadošie uzņēmumi ir ienākuši 8 collu tirgū. Vietējie attīstības projekti galvenokārt ir 6 collu. Pašlaik, lai gan lielākā daļa vietējo uzņēmumu joprojām balstās uz 4 collu ražošanas līnijām, nozare pakāpeniski paplašinās līdz 6 collu līnijām, un, attīstoties 6 collu atbalsta iekārtu tehnoloģijai, pakāpeniski uzlabojas arī vietējā SiC substrātu tehnoloģija, kas atspoguļos liela izmēra ražošanas līniju apjomradītus ietaupījumus, un pašreizējā vietējā 6 collu masveida ražošanas laika starpība ir samazinājusies līdz 7 gadiem. Lielāks vafeļu izmērs var palielināt atsevišķu mikroshēmu skaitu, uzlabot ražas līmeni un samazināt malu mikroshēmu īpatsvaru, un pētniecības un attīstības izmaksas un ražas zudumi saglabāsies aptuveni 7% apmērā, tādējādi uzlabojot vafeļu izmantošanu.
Ierīču projektēšanā joprojām ir daudz grūtību
SiC diodes komercializācija pakāpeniski uzlabojas, un pašlaik vairāki vietējie ražotāji ir izstrādājuši SiC SBD produktus. Vidēja un augsta sprieguma SiC SBD produktiem ir laba stabilitāte. Transportlīdzekļu OBC SiC SBD + SI IGBT tranzistori tiek izmantoti, lai panāktu stabilu strāvas blīvumu. Pašlaik Ķīnā nav šķēršļu SiC SBD produktu patentēšanai, un atšķirība no ārvalstīm ir neliela.
SiC MOS joprojām ir daudz grūtību, joprojām pastāv plaisa starp SiC MOS un ārvalstu ražotājiem, un attiecīgā ražošanas platforma joprojām tiek izstrādāta. Pašlaik ST, Infineon, Rohm un citi 600–1700 V SiC MOS ir sasnieguši masveida ražošanu un parakstījuši līgumus un piegādājuši daudzām ražošanas nozarēm, savukārt pašreizējais vietējais SiC MOS dizains ir būtībā pabeigts, vairāki dizaina ražotāji strādā ar rūpnīcām vafeļu plūsmas stadijā, un vēlākai klientu pārbaudei vēl ir nepieciešams zināms laiks, tāpēc līdz liela mēroga komercializācijai vēl ir ilgs laiks.
Pašlaik plaknes struktūra ir galvenā izvēle, un nākotnē tranšejas tips tiks plaši izmantots augstspiediena jomā. Plaknes struktūras SiC MOS ražotāju ir daudz, plaknes struktūrai nav viegli radīt lokālas sabrukšanas problēmas salīdzinājumā ar gropēm, kas ietekmē darba stabilitāti, un tirgū zem 1200 V tai ir plašs pielietojuma vērtību klāsts, un plaknes struktūra ir relatīvi vienkārša ražošanas galā, lai atbilstu diviem ražojamības un izmaksu kontroles aspektiem. Gropēm ir tādas priekšrocības kā ārkārtīgi zema parazitārā induktivitāte, ātrs pārslēgšanās ātrums, zemi zudumi un relatīvi augsta veiktspēja.
2. SiC vafeļu jaunumi
Silīcija karbīda tirgus ražošanas un pārdošanas apjoma pieaugums, pievērsiet uzmanību strukturālajai nelīdzsvarotībai starp piedāvājumu un pieprasījumu


Līdz ar straujo augstfrekvences un lieljaudas jaudas elektronikas tirgus pieprasījuma pieaugumu, pakāpeniski ir kļuvusi redzama silīcija bāzes pusvadītāju ierīču fiziskās robežas sašaurinājums, un pakāpeniski ir industrializējušies trešās paaudzes pusvadītāju materiāli, ko pārstāv silīcija karbīds (SiC). No materiāla veiktspējas viedokļa silīcija karbīdam ir 3 reizes lielāks joslas platums nekā silīcija materiālam, 10 reizes lielāks kritiskā sabrukšanas elektriskā lauka stiprums un 3 reizes lielāka siltumvadītspēja, tāpēc silīcija karbīda jaudas ierīces ir piemērotas augstfrekvences, augsta spiediena, augstas temperatūras un citiem lietojumiem, palīdzot uzlabot jaudas elektronisko sistēmu efektivitāti un jaudas blīvumu.
Pašlaik tirgū pakāpeniski ienāk SiC diodes un SiC MOSFET, un ir pieejami nobriedušāki produkti, starp kuriem dažās jomās SiC diodes tiek plaši izmantotas silīcija diožu vietā, jo tām nav reversās atgūšanas uzlādes priekšrocību; SiC MOSFET pakāpeniski tiek izmantots arī automobiļos, enerģijas uzkrāšanā, uzlādes pāļos, fotoelektriskajos elementos un citās jomās; automobiļu lietojumprogrammu jomā arvien izteiktāka kļūst modularizācijas tendence, un SiC izcilās veiktspējas sasniegšanai ir jābalstās uz progresīviem iepakošanas procesiem, lai sasniegtu tehniski relatīvi nobriedušu korpusa blīvējumu kā galveno, nākotnes vai plastmasas blīvējuma izstrādes virzienu, tā pielāgotās izstrādes īpašības ir piemērotākas SiC moduļiem.
Silīcija karbīda cenu krituma ātrums vai pāri iedomām

Silīcija karbīda ierīču pielietojumu galvenokārt ierobežo augstās izmaksas, SiC MOSFET cena tajā pašā līmenī ir 4 reizes augstāka nekā uz Si bāzes veidotā IGBT cena, jo silīcija karbīda process ir sarežģīts, monokristāla augšana un epitaksiālā transformācija ir ne tikai skarba videi, bet arī augšanas ātrums ir lēns, un monokristāla apstrādei substrātā jāiziet cauri griešanas un pulēšanas procesam. Pamatojoties uz pašu materiālu īpašībām un nenobriedušu apstrādes tehnoloģiju, vietējā substrāta raža ir mazāka par 50%, un dažādi faktori noved pie augstām substrāta un epitaksiālās transformācijas cenām.
Tomēr silīcija karbīda ierīču un uz silīcija bāzes veidoto ierīču izmaksu sastāvs ir diametrāli pretējs, priekšējā kanāla substrāta un epitaksiālās izmaksas veido attiecīgi 47% un 23% no visas ierīces, kopā aptuveni 70%, aizmugurējā kanāla ierīces projektēšanas, ražošanas un blīvēšanas saites veido tikai 30%, uz silīcija bāzes veidoto ierīču ražošanas izmaksas galvenokārt koncentrējas aizmugurējā kanāla vafeļu ražošanā aptuveni 50%, un substrāta izmaksas veido tikai 7%. Silīcija karbīda nozares ķēdes vērtības apvērsuma fenomens nozīmē, ka augšupējiem substrāta epitaksiālajiem ražotājiem ir galvenās tiesības izteikties, kas ir vietējo un ārvalstu uzņēmumu izkārtojuma atslēga.
No dinamiskā tirgus viedokļa, samazinot silīcija karbīda izmaksas, papildus silīcija karbīda garo kristālu un griešanas procesa uzlabošanai, tiek paplašināts arī vafeļu izmērs, kas ir arī nobriedis pusvadītāju attīstības ceļš pagātnē. Wolfspeed dati liecina, ka, uzlabojot silīcija karbīda substrātu no 6 collām līdz 8 collām, kvalificētu mikroshēmu ražošana var palielināties par 80–90% un palīdzēt uzlabot ražu. Var samazināt kopējās vienības izmaksas par 50%.
2023. gads ir pazīstams kā "8 collu SiC pirmais gads", un šogad vietējie un ārvalstu silīcija karbīda ražotāji paātrina 8 collu silīcija karbīda ražošanu, piemēram, Wolfspeed veica trakas investīcijas 14,55 miljardu ASV dolāru apmērā silīcija karbīda ražošanas paplašināšanai, un svarīga šīs investīcijas daļa bija 8 collu SiC substrātu ražotnes būvniecība. Lai nodrošinātu 200 mm SiC neapstrādāta metāla piegādi vairākiem uzņēmumiem nākotnē, arī vietējie Tianyue Advanced un Tianke Heda ir parakstījuši ilgtermiņa līgumus ar Infineon par 8 collu silīcija karbīda substrātu piegādi nākotnē.
Sākot ar šo gadu, silīcija karbīda izmērs pieaugs no 6 collām līdz 8 collām, un Wolfspeed prognozē, ka līdz 2024. gadam 8 collu substrāta vienības mikroshēmas izmaksas salīdzinājumā ar 6 collu substrāta vienības mikroshēmas izmaksām 2022. gadā samazināsies par vairāk nekā 60 %, un izmaksu samazinājums vēl vairāk atvērs lietojumprogrammu tirgu, liecina Ji Bond Consulting pētījumu dati. Pašreizējā 8 collu produktu tirgus daļa ir mazāka par 2 %, un paredzams, ka tirgus daļa līdz 2026. gadam pieaugs līdz aptuveni 15 %.
Patiesībā silīcija karbīda substrāta cenas krituma temps var pārsniegt daudzu cilvēku iztēli, pašreizējais 6 collu substrāta tirgus piedāvājums ir 4000–5000 juaņas/gab., salīdzinot ar gada sākumu, tas ir ievērojami samazinājies, un nākamgad paredzams, ka tas nokritīsies zem 4000 juaņām. Ir vērts atzīmēt, ka daži ražotāji, lai iegūtu pirmo tirgu, ir samazinājuši pārdošanas cenu līdz zemāk esošajai izmaksu līnijai. Atvērts cenu kara modelis, galvenokārt koncentrējoties uz silīcija karbīda substrāta piegādi, kas ir bijusi relatīvi pietiekama zemsprieguma jomā, vietējie un ārvalstu ražotāji agresīvi paplašina ražošanas jaudu vai ļauj silīcija karbīda substrāta pārprodukcijai attīstīties agrāk, nekā iedomāts.
Publicēšanas laiks: 2024. gada 19. janvāris
