SiC silīcija karbīdsIerīce attiecas uz ierīci, kas izgatavota no silīcija karbīda kā izejvielas.
Atbilstoši dažādajām pretestības īpašībām to iedala vadošās silīcija karbīda jaudas ierīcēs undaļēji izolēts silīcija karbīdsRadiofrekvenču (RF) ierīces.
Silīcija karbīda galvenās ierīces formas un pielietojumi
SiC galvenās priekšrocības salīdzinājumā arSi materiāliir:
SiC joslas atstarpe ir 3 reizes lielāka nekā Si, kas var samazināt noplūdi un palielināt temperatūras toleranci.
SiC sabrukšanas lauka stiprums ir 10 reizes lielāks nekā Si, tas var uzlabot strāvas blīvumu, darba frekvenci, izturēt sprieguma jaudu un samazināt ieslēgšanas/izslēgšanas zudumus, kas ir piemērotāks augstsprieguma lietojumprogrammām.
SiC elektronu piesātinājuma dreifa ātrums ir divreiz lielāks nekā Si, tāpēc tas var darboties augstākā frekvencē.
SiC siltumvadītspēja ir 3 reizes lielāka nekā Si, labāka siltuma izkliedes veiktspēja, tas var atbalstīt augstu jaudas blīvumu un samazināt siltuma izkliedes prasības, padarot ierīci vieglāku.
Vadītspējīgs substrāts
Vadītspējīgs substrāts: no kristāla noņemot dažādus piemaisījumus, īpaši sekla līmeņa piemaisījumus, lai panāktu kristāla raksturīgo augsto pretestību.
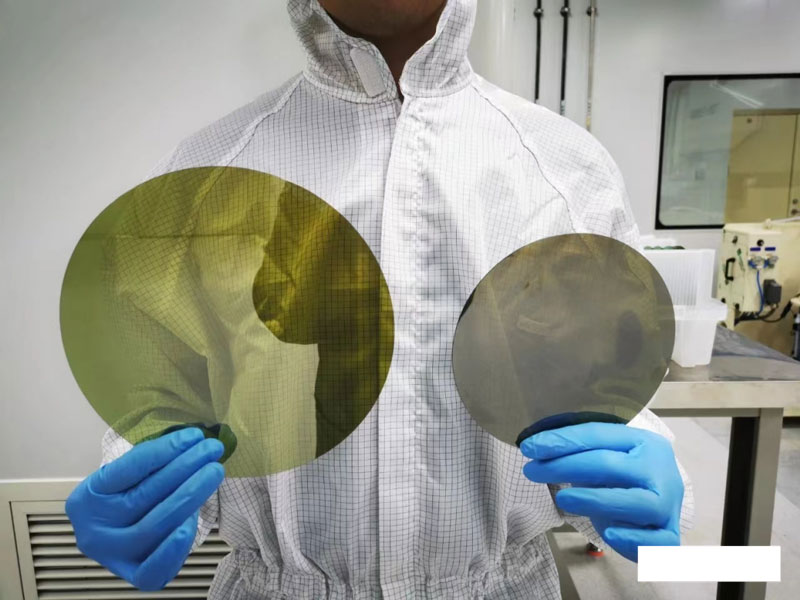
Vadītspējīgssilīcija karbīda substrātsSiC vafele
Vadītspējīga silīcija karbīda barošanas ierīce tiek izgatavota, uz vadoša substrāta uzklājot silīcija karbīda epitaksiālo slāni un tālāk apstrādājot silīcija karbīda epitaksiālo loksni, tostarp ražojot Šotki diodes, MOSFET, IGBT utt., un to galvenokārt izmanto elektriskajos transportlīdzekļos, fotoelektriskās enerģijas ražošanā, dzelzceļa transportā, datu centros, uzlādes stacijās un citā infrastruktūrā. Veiktspējas ieguvumi ir šādi:
Uzlabotas augstspiediena īpašības. Silīcija karbīda elektriskā lauka stiprums ir vairāk nekā 10 reizes lielāks nekā silīcijam, kas padara silīcija karbīda ierīču augstspiediena izturību ievērojami augstāku nekā līdzvērtīgām silīcija ierīcēm.
Labākas augstas temperatūras īpašības. Silīcija karbīdam ir augstāka siltumvadītspēja nekā silīcijam, kas atvieglo ierīces siltuma izkliedi un paaugstina robeždarba temperatūru. Augsta temperatūras izturība var ievērojami palielināt jaudas blīvumu, vienlaikus samazinot dzesēšanas sistēmas prasības, lai terminālis varētu būt vieglāks un miniaturizētāks.
Zemāks enerģijas patēriņš. ① Silīcija karbīda ierīcei ir ļoti zema ieslēgšanas pretestība un zemi ieslēgšanās zudumi; (2) Silīcija karbīda ierīču noplūdes strāva ir ievērojami mazāka nekā silīcija ierīcēm, tādējādi samazinot jaudas zudumus; ③ Silīcija karbīda ierīču izslēgšanas procesā nav strāvas sabrukšanas fenomena, un pārslēgšanās zudumi ir zemi, kas ievērojami uzlabo pārslēgšanās frekvenci praktiskos pielietojumos.
Daļēji izolēts SiC substrāts: N dopings tiek izmantots, lai precīzi kontrolētu vadošu produktu pretestību, kalibrējot atbilstošo attiecību starp slāpekļa dopinga koncentrāciju, augšanas ātrumu un kristāla pretestību.


Augstas tīrības pakāpes daļēji izolējošs substrāta materiāls
Daļēji izolētas silīcija oglekļa bāzes RF ierīces tiek tālāk izgatavotas, audzējot gallija nitrīda epitaksiālo slāni uz daļēji izolēta silīcija karbīda substrāta, lai sagatavotu silīcija nitrīda epitaksiālo loksni, tostarp HEMT un citas gallija nitrīda RF ierīces, kuras galvenokārt izmanto 5G sakaros, transportlīdzekļu sakaros, aizsardzības lietojumprogrammās, datu pārraidē, kosmosa un kosmosa nozarē.
Silīcija karbīda un gallija nitrīda materiālu piesātinātā elektronu dreifa ātrums ir attiecīgi 2,0 un 2,5 reizes lielāks nekā silīcijam, tāpēc silīcija karbīda un gallija nitrīda ierīču darbības frekvence ir lielāka nekā tradicionālajām silīcija ierīcēm. Tomēr gallija nitrīda materiāla trūkums ir slikta karstumizturība, savukārt silīcija karbīdam ir laba karstumizturība un siltumvadītspēja, kas var kompensēt gallija nitrīda ierīču slikto karstumizturību, tāpēc rūpniecībā kā substrātu tiek izmantots daļēji izolēts silīcija karbīds, un RF ierīču ražošanai uz silīcija karbīda substrāta tiek audzēts gan epitaksiālais slānis.
Pārkāpuma gadījumā sazinieties ar dzēšanas dienestu.
Publicēšanas laiks: 2024. gada 16. jūlijs
